지금까지 Display Driver IC 동작 원리를 시작으로 종류 및 구조까지 알아보는 시간을 가져보았습니다. 이번 회차에는 DDI에 필요한 부속품들이 디스플레이 제품에 적용되기 위해 어떤 형식으로 구성되어 적용되는지에 관련된 DDI 패키지에 대해 알아보는 시간을 가져보도록 하겠습니다.
* DDI 패키지에 대하여
DDI 패키지란 DDI를 구동시키기 위해 필요한 단위 부품들로 구성된 구성체로써 앞서 1, 2편에서 배웠던 DDI, T-Con(Timing Controller), PMIC(Power Management IC)와 더불어 입력한 데이터를 일시적으로 저장하여 송출할 수 있게끔 도와주는 GRAM (Graphic Random Access Memory)의 부속품이 포함된 것을 DDI 패키지라 칭합니다 (그림 1 참조). 이러한 DDI 패키지 부속품들은 접착 공법들을 통해 다양한 기판 상에 DDI 패키지가 구성되는 것에 따라 방식이 구분화됩니다.

그림1. DDI 패키지 구성 모식도
* 실장 기판에 따른 DDI 패키지 구분 첫 번째 : COG 방식
DDI 패키지는 디스플레이의 종류에 따라 부착되는 방식이 서로 다르게 적용됩니다. 우선, 초창기 DDI 패키지 모델인 COG (Chip on Glass) 방식에 대해 알아보고자 합니다. COG 방식은 그림 2(a)에서와 같이 Glass 기판 위에 DDI 패키지를 부착하는 방식을 뜻하며 통상적으로 알려진 유연(Flexible) 특성이 없는 구부러지지 않는(Rigid) 디스플레이에 활용됩니다. 이러한 유리 기판 상에 DDI 패키지가 부착된 COG 방식을 구현하기 위해서는 특정 방향으로만 전기를 통하도록 만들어진 ACF(Anisotropic Conductive Film)를 활용한 부착 방식을 사용하게 됩니다. ACF는 연결하고자 하는 유리 기판과 DDI 패키지 사이에 위치시킨 후 압착함으로써 압착 방향으로만 전기가 흐름과 동시에 접착성까지 겸비한 특성을 지니고 있어, COG 방식의 구동을 가능하게 하는 역할을 합니다. 이렇게 제작된 COG 방식의 특징 중의 하나는 유리 기판상에 DDI 패키지가 존재하기 때문에 그림 2(b)에서 볼 수 있듯이 베젤(Bezel) 영역을 최소화하기에는 한계점이 존재하며, 주로 소형 LCD 디스플레이 패널에 주로 적용됩니다.

그림 2. COG (Chip on Glass) 구성 모식도: (a) Top view, (b) Side view
* 실장 기판에 따른 DDI 패키지 구분 두 번째 : COF 방식
다음은 COF (Chip on Film) 방식의 DDI 패키지를 설명 드리도록 하겠습니다. COF 방식은 COG의 한계인 얇은 베젤의 구현이 어렵다는 단점을 보완하기 위해 개발된 방식입니다. 그림 3(a)에서 알 수 있듯이, COG와 같이 유리기판 위에 패널이 있으나, DDI 패키지를 인쇄회로가 형성된 박막(Film) 기판에 실장한다는 차이점이 있습니다. 박막 기판은 PI(Polyimide)의 유연 재료로 구성되어 Flexible 또는 Bendable의 특성이 우수하다는 특징이 있습니다. 이러한 유연 기판에 DDI 패키지를 부착하기 위해 1980년대 후반 반도체 분야에서 활용된 TAB(Tape Automated Bonding) 기술의 일종으로 활용하여 부착하고 있습니다. COF의 부착 방식은 DDI 패키지에 금속 bump를 구성한 후 인쇄회로가 형성된 PI 기판에 압착하는 형식으로 정밀한 (Fine) pitch의 공정이 가능하다는 특징이 있습니다. 이렇게 제작된 COF 방식은 그림 3(b)와 같이 FPCB(Flexible Printed Circuit Board)와 함께 박막 기판 위에 있는 DDI 패키지까지 기판 밑으로 접을 수 있게 됩니다. 이로써 COF 방식은 COG에서의 한계점이었던 두꺼운 베젤 영역을 줄일 수 있는 해결책으로 제시되어 디스플레이 패널 종류에 상관없이 적용되고 있습니다.
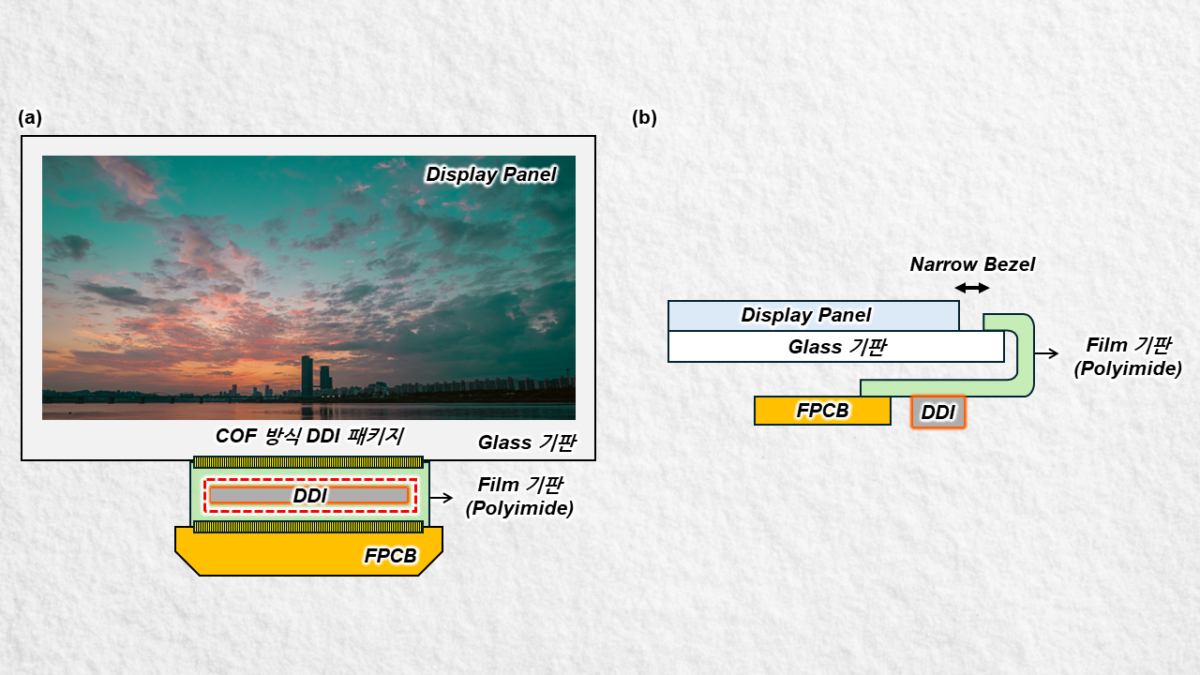
그림 3. COF (Chip on Film) 구성 모식도: (a) Top view, (b) Side view
앞서 설명 드린 기존 COF 방식의 DDI 패키지의 경우, 그림 4(a)와 같이 PI 기판의 단면만을 사용한 1Metal COF 방식이였다면, 그림 4(b)와 같이 PI기판의 양면을 모두 활용할 수 있는 2Metal COF가 최첨단 디스플레이 제품에서 각광받고 있습니다. 그림 4(b)의 2Metal COF의 경우 PI 기판에 약 25μm 크기의 Via hole을 형성한 뒤, PI 기판 양면에 초미세회로를 구현하는 기술입니다. 2Metal COF 방식의 경우 PI 필름 양쪽 면에 4,000개 이상의 채널회로를 형성할 수 있으며, 기존 1Metal COF 방식보다 많은 수의 채널회로를 형성할 수 있기에 디스플레이 화면에서 보여줄 수 있는 이미지 해상도가 1Metal COF 대비 더욱 증가하게 됩니다. 이에 초고해상도 디스플레이 화면을 요구하는 XR 기기에서는 *“스크린 도어 이펙트”를 줄이기 위해 DDI 패키지 부착 기술로 2Metal COF 방식이 이용되고 있습니다.
(*스크린 도어 이펙트: XR/VR 기기가 낮은 해상도를 갖게 될 경우, 눈앞에 배치된 이미지 픽셀과 픽셀간 경계선이 보이는 현상)
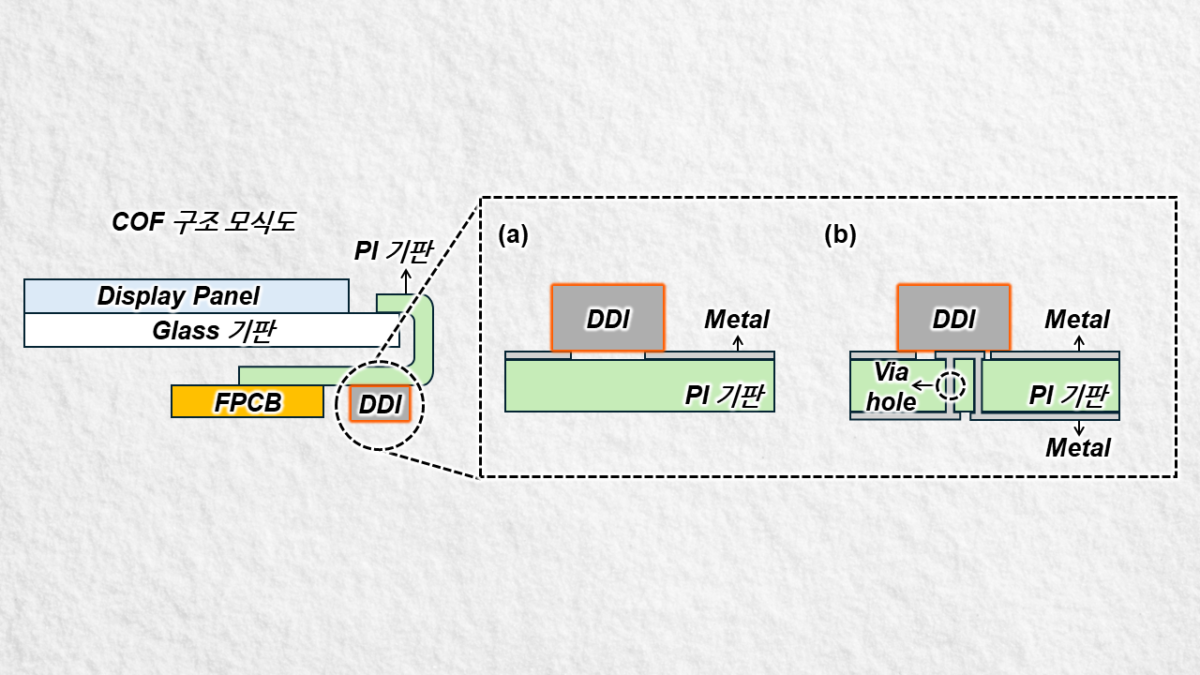
그림 4. (a) 1Metal 및 (b) 2Metal COF 구조 모식도
* 실장 기판에 따른 DDI 패키지 구분 세 번째 : COP 방식
마지막으로 COP (Chip On Plastic) 방식의 DDI 패키지에 대해 설명 드리겠습니다. COP 방식의 경우 앞서 설명 드린 COG와 COF간의 가장 큰 차이점은 그림 5(a)에서 볼 수 있듯이 디스플레이 패널 기판을 PI 기판을 사용한다는 점입니다. COF와 같이 PI 박막 위에 DDI를 추가로 부착하지 않고 연장된 패널 기판 위에 DDI 패키지 및 FPCB를 부착하게 되는 구조를 가집니다. 본 방식은 베젤 영역을 감소시킬 수 있었던 COF 방식보다 더 작은 곡률 반경을 구현할 수 있어 그림 5(b)에서 볼 수 있듯이 COF 방식 대비 얇은 베젤을 구현할 수 있다는 장점을 가지고 있습니다. COP 방식은 Flexible 및 Bendable 디스플레이에 활용될 수 있으며 Full screen 디스플레이에 적합한 DDI 패키지 부착 기술입니다.

그림 5. COP (Chip on Plastic) 구성 모식도: (a) Top view, (b) Side view
앞서 설명 드린 COG, COF, COP 방식이 디스플레이에 적용되었을 때 DDI 패키지 및 FPCB가 디스플레이 후면으로 구부러짐의 정도에 따라 변화되는 베젤 영역을 그림 6에서와 같이 모식도로 비교해 보았습니다. COF는 약 1.5 mm의 곡률 반경(Bending Radius)을 기반으로 DDI 영역을 후면으로 보내어 COG 대비 얇은 베젤 영역을 구현할 수 있는 특징을 지니고 있습니다. 더 발전된 COP 방식의 경우에는 디스플레이 패널의 기판 자체가 구부러지기 때문에 COF 대비 더 낮은 곡률 반경을 지닐 수 있게 되고, 이에 따라 베젤이 거의 없는(Near Bezel Less) 디스플레이를 구현할 수 있는 특징을 지니고 있습니다.

그림 6. COG, COF, COP 방식 별 베젤 영역 감소 모식도
* 베젤 영역의 국소화를 위한 PCB의 변화 : FPCB
추가적으로 COG, COF, COP 방식에는 FPCB가 함께 활용되고 있습니다. 그림 8과같이 FPCB는 기존 구부러지지 않는 에폭시 기판을 사용하는 PCB와 달리 PI 기판 위에 인쇄회로가 구성된 PCB로써 얇은 두께 및 유연 특성을 가집니다. 이러한 특성으로 인해 FPCB를 구부림으로써 디스플레이 패널의 후면에 배치가 가능하여 디스플레이의 베젤 공간을 획기적으로 감소시킬 수 있다는 장점을 가지고 있습니다. 이는, 디스플레이 종류에 상관없이 모든 디스플레이에 활용되고 있으며 공간 활용과 무게 등에서의 장점으로 인해 모바일 기기에 FPCB의 활용성이 극대화되고 있습니다.
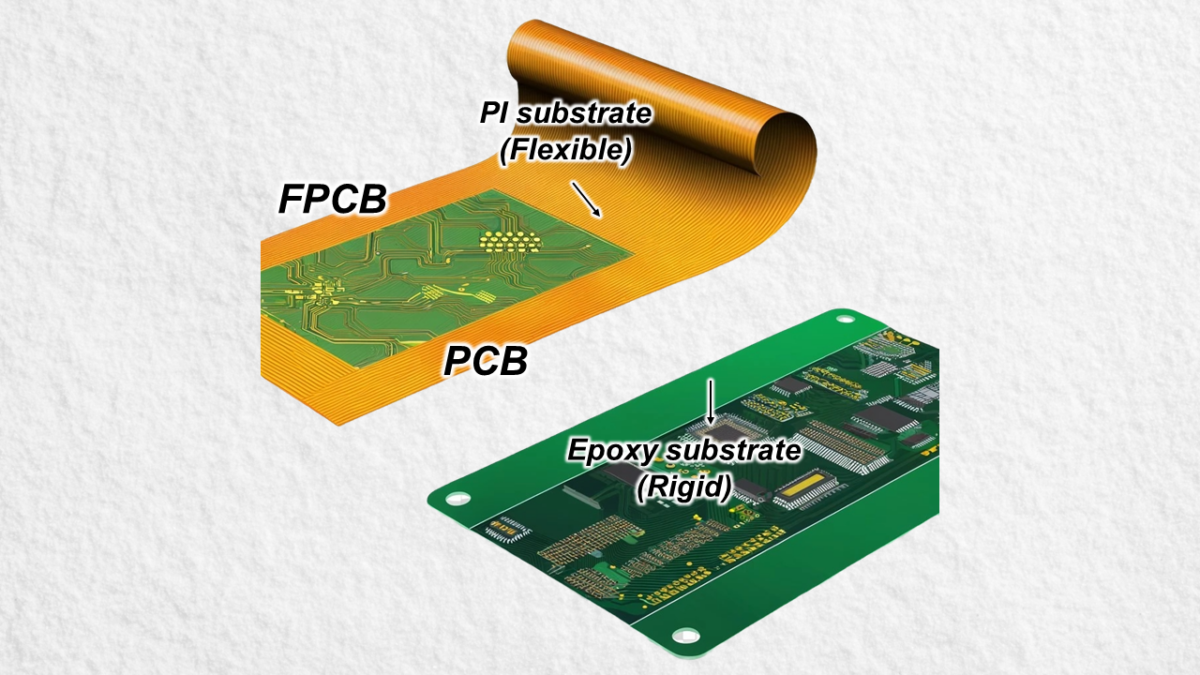
그림 7. FPCB 및 PCB 구조 모식도
* 마무리하며…
이번 DDI 패키지를 끝으로, DDI가 어떻게 작동하고, 그 종류는 무엇인지 배워보는 시간을 가져보았습니다. 우리가 매일 마주하는 스마트폰, 전광판, 모니터 화면을 작동시키기 위해서 우리 눈에 보이지 않는 배젤 너머에서 DDI는 매순간마다 작동하고 있습니다. 3번에 걸쳐 작성된 이번 기고글이 디스플레이 분야에서 첫발을 내딛는 사람들에게 영감을 주길 바랍니다. DDI가 디스플레이의 선명한 화면을 구현하듯이 창의력과 도전 정신이 가득한 디스플레이 인재들이 이끌어 나갈 새로운 시대를 기대해 보며 본 글을 마치도록 하겠습니다.

[LX세미콘 SNS 채널 방문하기]
LX세미콘 블로그 (Semicon人Us)
news.lxsemicon.com
LX세미콘 네이버 포스트
post.naver.com/lxsemiconpr
LX세미콘 유튜브
youtube.com/@LX_Semicon
LX세미콘 페이스북
facebook.com/LXSemicon
LX세미콘 홈페이지
lxsemicon.com