메모리와 시스템 반도체 제조를 위한 표준 반도체 공정은 전공정과 후공정으로 설명할 수 있습니다. 신호의 입력과 출력용 변환기, 즉 MEMS 기술을 적용한 마이크로 센서와 액추에이터 소자에서는 종종 반도체 공정 기술에 더하여 기계적인 가공 공정이 더해집니다. 이를 MEMS용 마이크로머시닝 혹은 미세가공 기술이라고 하죠.
마이크로머시닝 공정
MEMS 소자의 경우 특정 용도가 먼저 정해지면, 성능과 크기, 가격 요소 등 제반 스펙이 여기에 맞도록 시스템(반도체에서 블록 다이어그램 및 논리 설계에 해당함) 및 소자 차원에서의 설계, 그리고 모델링과 시뮬레이션이 먼저 시작되는데, 이 과정에서는 기본적인 마이크로 일렉트로닉스 관점에 더하여 마이크로 머신, 마이크로 시스템 등의 요소가 함께 고려되어야 합니다. 다음으로 공정 설계가 진행되고, 여기에는 기본 반도체 공정에 대하여 마이크로머시닝 관련 공정들, 즉 벌크 혹은 표면 마이크로 머시닝, 깊은 반응성 이온 식각(Deep Reactive Ion Etching, DRIE), 기판 접합(wafer bonding) 등의 MEMS 특화적인 공정들이 가미되죠.
공정 설계에 따라 반도체용 청정실에서 제작이 되고, 이는 공정 테스트를 거쳐 바로 패키징 및 테스트 과정으로 넘어가기도 하고, 공정 오차 등이 발생하였을 경우, 다시 제작되거나 혹은 일부 수정, 재순환 제작 과정을 거치기도 합니다.

이와 같이 MEMS 소자, 부품, 시스템의 제작에는 반도체 공정과 특화된 마이크로머시닝 공정이 함께 적용됩니다. 이 과정을 통하여 전자-기계적인 구조물과 반도체 회로가 함께 집적화된 MEMS 제품들을 만들어 가죠. 일반적으로 반도체 공정을 먼저 수행하고, 다음으로 MEMS 공정을 이어가나 꼭 그렇지만은 않습니다. MEMS 공정을 먼저 행할 수도 있고, 혹은 반도체 공정과 MEMS 공정을 상황에 맞춰 공정별로 번갈아 진행할 수도 있습니다. 반도체 회로부와 MEMS 구조물부를 단일 칩에 만들 수도 있고, 별도의 칩에 만들어서 하나의 패키지 안에 넣을 수도 있으며, 혹은 회로 칩과 MEMS 칩이 각각 패키지 안에 실장되기도 하죠.
이와 같이 일반 반도체인 집적회로의 제작에 비하여 MEMS의 제작은 매우 다양하며, 메모리 반도체보다는 훨씬 소량 다품종일 경우가 많습니다.
먼저 실리콘 미세 가공은 몸체 미세 가공(bulk micromachining)과 표면 미세 가공(surface micromachining)으로 구분할 수 있습니다. 몸체 가공은 말 그대로 (실리콘) 웨이퍼의 몸체를 가공하는 것으로 건식이나 습식 식각을 통하여 웨이퍼 몸체의 선택 영역들이 가공되죠.
특히 습식 식각의 경우, 식각이 주로 일어나는 방향성에 따라 등방성(isotropic)과 비등방성(anisotropic)으로 나누어지는데, 비등방성 식각은 결정 의존성 식각(Orientation Dependent Etching, ODE)이라고 하며, 용어 그대로 단결정 실리콘 웨이퍼의 결정 방향에 따라 서로 다른 식각률을 가지고 식각이 이루어진다는 특징이 있습니다. 표면 미세 가공은 웨이퍼의 표면에 희생층과 구조층들을 증착 등의 과정으로 쌓은 뒤, 희생층만 선택적으로 제거하여 구조층에게 움직이는 기능이나 혹은 특별한 형상을 갖도록 하는 방법이죠.

이상과 같은 몸체 및 표면 미세 가공 기술에 더하여 LIGA라는 공정이 있죠. 이는 독일어로 사진 식각(LI)과 전기 도금(G), 그리고 몰딩(A)을 의미하며 두꺼운 감광막에 대해 선택적 노광과 식각 과정을 통하여 패터닝하고 선택적으로 제거하여서 틀을 만들고, 이를 이용하여 다양한 소재의 구조물들을 찍어내는 방법입니다. 종횡비의 선택이 자유롭고, 소재도 플라스틱이나 금속 등으로 다양하게 적용할 수 있죠.
이상과 같이 몸체 및 표면 미세 가공, LIGA 등의 공정을 이용하여 다양한 MEMS 구조물들이 만들어집니다. 이러한 구조물들은 서로 수직 방향으로 쌓여지기도 하고, 전기 및 기계적으로 연결, 접합 등도 되며, MEMS 소자나 마이크로 시스템으로 완성이 됩니다. 구조물 제작 후에 조립이나 패키징 과정 또한 기존 반도체 공정과는 달리, 매우 다양하죠. 이상과 같이 MEMS 공정은 반도체 공정 수준의 청정실에서 기본적인 반도체 공정에 더하여 결정 의존성 식각, DRIE와 같은 특화 공정들, 이를 통한 몸체 및 표면 미세 가공, LIGA와 같은 비실리콘 가공, 기판들 간의 접합과 조립, 패키징 등으로 이루어집니다.
실리콘의 식각, 깎아내기
MEMS용 미세 가공의 기본은 식각입니다. 특히 습식 식각, 결정 의존성 식각이 중요합니다. 1960년대에 강한 알칼리 용액들이 단결정 실리콘의 식각에 사용되었는데, 결정 방향에 따라 식각률이 달랐습니다. 즉, 실리콘의 세 개의 주요 결정 방향에서 <100>, <110>, 그리고 <111> 순서대로 식각률이 감소하죠. 이는 각각의 방향으로 식각액이 진행할 때 만나게 되는 실리콘 원자의 수가 증가하는 순서입니다. 이에 더하여 실리콘의 식각률이 뚝 떨어질 만큼 급격히 감소하는 경우도 있었는데, 예를 들어 붕소를 강하게 도핑한 영역에서도 이런 일이 발생하였죠.
특히, 결정 의존성 식각 기술은 실리콘 결정 방향에 따라 달라지는 식각률, 높은 도핑 농도에서 식각률의 급격한 저하, 그리고 비교적 쉽게 만들어지는 식각 마스킹 박막 등으로 MEMS의 미세 가공에 활발히 적용되었습니다. 여기에는 EDP (EthyleneDiamine Pyrocatechol) 수용액, KOH 용액, 하이드라진 수용액, 그리고 수산화나트륨 수용액 등이 있죠. 이들은 단결정 실리콘의 밀러 지수에 따라 서로 다른 식각률을 가지므로, 실리콘 웨이퍼의 결정성과 도핑 영역, 그리고 결정 의존성 식각 용액을 고려하여 식각 마스크 패턴과 식각 용액들을 적절히 선택, 사용한다면, 특히 몸체 미세 가공에서 다양한 구조물들의 정교한 제작이 가능합니다.
이와 같이 실리콘의 습식 식각만으로도 MEMS용 구조물들을 비교적 다양하게 만들 수 있는데, 예를 들어보면 유체의 저장을 위한 미세 공동, 유체 분사용 노즐, 힘이나 압력에 탄성 변형될 수 있는 얇은 막, 고유 진동수로 진동이 가능한 외팔보, 열적인 절연이나 가열을 위한 미세 가교 등을 들 수 있습니다.

또한 적절한 깊이나 크기의 구조물을 제작하는데 있어서, 어느 시점에서 식각이 자동적으로 멈추어야 하는데, 이를 위해 필요한 기술이 자동 식각 정지(automatic etch-stop)입니다. 단순한 화학적 방법으로는 붕소를 높은 농도로 도핑하여, 실리콘 내부에 스트레스를 강하게 발생시켜서 이로 인해 식각률을 급격히 낮추는 방법이 있죠. 다만, 이 방법은 고농도 도핑층으로 인하여 캐리어의 확산이나 재분포가 발생하여 전기적인 오작동의 우려도 있고, 또한 소자 제작을 위해 고농도 도핑 영역에 또 다른 도핑을 행할 경우에 공정이 어려우며, 도핑 영역에서의 스트레스가 기계적인 성능을 저하시킬 수 있다는 단점도 함께 가지고 있습니다.
자동 식각 정지를 위한 전기화학적 방법도 있는데, 기본적으로 반도체 p형 기판과 n형 에피텍셜 층으로 이루어진 p-n 접합을 필요로 하죠. 이러한 다이오드 구조에 역방향 전압을 인가한 상태에서 식각 용액 내에 담그면, 역방향 바이어스로 인해 전류가 흐르지 않는 상태에서는 p형 기판에 대해 정상적인 식각이 진행되다가 n형 에피층만 남게 되면 전류가 용액 내를 흐르면서 에피층의 표면에 양극 산화 반응을 유도, 산화막이 형성되면서 식각 마스크로 작용을 합니다. 따라서 n형 에피층의 두께로 조절되는 다이아프램 등의 구조가 가능해지죠. 이러한 결정 의존1성 식각과 함께 자동 식각 정지 기법을 함께 적절히 이용하면 미세 공동이나 얇은 막, 혹은 노즐 구조 등을 설계에 따라 정확한 규격으로 얻을 수 있습니다.
몸체의 미세 가공, 깎고 다듬기
몸체 미세 가공은 웨이퍼에서 구조물로 사용되지 않을 영역을 제거하는 과정이며, MEMS 구조물은 기판 내부에 만들어집니다. 구조물의 표면의 면적은 넓고 높이는 웨이퍼의 두께에 해당하므로 종횡비(aspect ratio)가 대체로 작다는 한계가 있습니다. 공정은 비교적 간단하고 잘 정립이 되어 있으며, 주로 단순한 모양의 구조물 제작에 이용되며, 회전과 같이 비교적 큰 변위로 운동하는 구조물을 만들기는 어렵습니다. 기계적 강도나 내구성은 우수하고, 기하학적 수치, 크기나 모양 등을 조절하기는 무난하죠. 주로 습식 식각 공정에 크게 의존하며, 특히 결정 의존성 식각이나 자동 식각 정지 기법 등을 종종 활용합니다.
몸체 미세 가공을 위한 습식 식각에는 등방성 식각과 비등방성인 결정 의존성 식각이 있으며, 등방성 식각에서는 교반 정도의 강약과 유무, 결정 의존성 식각에서는 단결정 실리콘의 결정면과 사용하는 식각 용액의 종류 등에 따라서 다양한 식각 프로파일을 얻을 수 있습니다. 이를 통하여 외팔보, 공동, 브릿지, 노즐, 다이아프램, 유로, 그리고 열적으로 고립된 구조와 얇고 가벼운 이음매를 갖는 무거운 추와 같은 구조들이 만들어지죠. 진동, 열이나 온도, 압력과 휨, 가속도와 각속도 등의 관성을 측정하거나, 유체의 흐름 경로, 저장과 같은 역할을 하는 구조들로 사용됩니다.
몸체 미세 가공의 단점으로는 공정이 비교적 가혹하여 주변 회로들의 손상 우려가 있고, 공정 시간이 길며 소모되는 식각 용액이나 재료들이 많아 생산성이나 환경 측면에서 일부 문제가 있죠. 그리고 결정 방향에 주로 의존하므로 실제 회로나 센서가 만들어지는 부분에 비해 가공되는 면적과 부피가 커서 불필요하게 소자의 크기가 커지고, 이로 인하여 한 장의 웨이퍼에서 만들어지는 전체 칩의 개수가 줄어듭니다. 이러한 문제점들은 패키지의 크기, 가격, 생산성과 환경 등에서 부담스러운 요인이 되고 있죠.
표면의 미세 가공, 쌓고 깎고 다듬기
표면 미세 가공의 경우 몸체 가공과 대비되는데, 웨이퍼 위에 쌓은 막들을 선택적으로 패터닝, 식각, 제거하는 과정을 거치며, 기판 자체의 가공이 거의 이루어지지 않습니다. 크고 무거운 구조물을 만드는 데는 적합하지 않으나, 웨이퍼의 두께와 무관하게 다양한 종횡비의 선택이 가능하며, 모양과 패턴 사이즈를 보다 넓고 섬세한 범위에서 선택, 조절할 수 있죠. 마스크 패턴에 절대적으로 의존하며, 구조층의 패터닝과 희생층의 제거로 구조물들이 만들어집니다. 회전이나 직선, 혹은 경사 왕복 운동 등 다양하게 움직이는 구조물들을 제작할 수 있으며, 재료 소모량이나 사용 면적의 절약에 있어서 훨씬 효율적입니다. 기계적인 내구성도 인정받고 있으며, 설계 자유도도 크고, CMOS 등 집적회로 공정과도 친화성이 좋습니다. 크기나 작은 구조물들도 충분히 가능하며, 주로 건식 식각에 의존하죠.

이는 기판의 표면 위에 희생층(sacrificial layer)과 구조층(structural layer)을 번갈아 적층한 뒤, 희생층만을 선택적으로 제거하는 방식으로, 마치 어린 시절에 흙 위에 손을 펴 놓고 흙을 손등 위에 쌓아 토닥거린 다음, 손을 빼내어서 만들어내던 두꺼비집을 연상하면 됩니다. 이때 ‘두껍아 두껍아 헌집 줄께 새집 다오’란 노래를 흥얼거리곤 했죠. 희생층으로는 주로 감광성 레지스트처럼 패터닝이 용이한 고분자, 혹은 실리콘 산화막과 같이 역시 쉽게 제거가 되며 특히 구조층과 시각 선택도가 높은 막들이 사용됩니다. 구조층으로는 다결정 실리콘이 주로 사용되지만, 제작하고자 하는 센서나 소자에 적합한 특성을 가진 물질들, 그리고 금속까지도 택할 수 있습니다.
표면 미세 가공으로 만들어지는 구조물, 나아가서는 마이크로 머신이나 부품들은 희생층과 구조층을 쌓아 올리고 선택적으로 제거하는 과정을 반복하는 횟수가 증가할수록 그 복잡도와 성능도 올라갑니다. 예를 들어, 산화막 희생층과 다결정 실리콘 구조층의 증착, 패터닝, 식각을 2회 정도하고 여기에 금속 전극들을 더하면, 회전하는 정전 마이크로 모터의 제작이 가능해집니다. 즉, 희생층과 구조층 공정 레벨이 증가할수록 단순한 외팔보 구조로부터 센서, 그리고 액추에이터, 궁극적으로는 마이크로 머신, 시스템 제작까지 이어질 수 있죠. 다층 레벨의 표면 미세 가공을 이용하면, 기판의 표면 위에 머리카락 굵기로 비견되는 다양한 물리 기계적인 요소, 구조, 부품들, 예를 들어 여러 관성 센서들, 흐름이나 열, 적외선, 바이오 센서 등에 적용되는 MEMS 구조물들, 그리고 미소 거울, 마이크로 체인, 기어, 모터 등과 같이 광학 혹은 기계적 시스템에 유용한 핵심 부품들, 나아가서는 머신 자체까지도 제작이 가능합니다.
실리콘이 아닌 재료들의 가공
지금까지 주로, 반도체 공정에 기반을 둔 실리콘의 미세 가공을 설명하였지만, MEMS에는 더 많고 다양한 소재들이 사용되고 있습니다. 예를 들어, MEMS 구조물이나 소자의 마운팅, 밀봉이나 패키징을 위한 유리 구조물, 보다 강하고 연성이 있는 소재인 금속류, 그리고 유연성과 생체 친화성을 강조한 플라스틱 소재 등이 대표적이죠. 이러한 소재들의 가공을 위해 식각 공정 이외에도 초정밀 선반, 드릴 가공, 레이저를 가용한 가공이나 절단, 용융을 통한 용접, 전기 방전, 아크를 이용한 드릴링, 그리고 주조와 틀을 이용한 몰딩 등 공정 방법들도 실로 다양하죠.
이러한 소재들과 공정을 통하여 보다 강하고, 휨과 같은 연성, 탄성 변형이 가능하고, 혹은 더 정교하거나 혹은 3차원 가공된 구조물들이 제작되어 소자나 시스템이 적용이 되고 있죠. 따라서, MEMS 기술로 만들 수 있는 소자나 기구, 장치, 혹은 기계 부품이나 요소들은 점점 더 많아지고 있으며, 그 응용도 또한 끝없이 확장을 하고 있습니다. 금속의 경우는 강도 및 연성과 함께 전기적인 전도성이나 작동 수명을 늘릴 수 있는 내구성 등에서 유리하며, MEMS에 종종 적용이 되고 있는 소재입니다. 몸체 가공부터 금속 박막을 이용한 표면 가공, 그리고 전기 도금과 몰딩을 통한 3차원 가공 등이 적용되고 있죠.
플라스틱 소재의 경우에는 소재 자체가 가볍고, 연성이 있어서 취성 물질의 단점인 크랙이 발생하지 않으며, 구조물이나 소자가 만들어진 후에도 형상 변형이 비교적 자유롭죠. 특히, 생체 친화성이 있어서, 생체의 피부 표면은 물론 내부에도 삽입하는 응용 분야에 효과적이며, 혹은 혈액과 같은 바이오 물질을 처리, 감지하는 용도로도 사용이 됩니다.
가공은 주로 몰딩을 이용하는데 공정이 쉽고 간단합니다. 좀 더 세부적으로 살펴보면, 몸체 미세 가공, 즉 두꺼운 플라스틱 구조물을 제작할 경우에는 인젝션 몰딩이나 엠보싱, 캐스팅, 접합, 라미네이팅 방법 등이 사용되며, 표면 미세 가공에 해당하는 얇은 구조물을 기판 표면에 만들 경우에는 스핀 캐스팅, 잉크젯 프린팅 등으로 후막을 도포한 뒤 패터닝하기도 하고, 희생층과 구조층을 사용, 선택적으로 패터닝하고 식각하는 공정이 이용되기도 하죠.
기판들의 접합, 서로 붙이기
웨이퍼, 혹은 기판 접합 기술은 미리 가공된 실리콘 기판이나 유리 기판 등을 서로 접합하여 물리적, 그리고 전기적으로 연결시키는 것을 말합니다. 이러한 기판 접합 기술은 두 종류로 구분이 되죠. 즉, 접합되는 기판들 사이에 아무런 접착제나 접합용 매개물이 없이 정전력이나 화학적 결합과 용융 과정을 통하여 접합이 일어나는 직접 접합(direct bonding)과 솔더나 프릿, 혹은 에폭시와 같은 접착 매개물을 이용하는 중간층을 사용하는 접합(bonding with intermediated layers)으로 구분할 수 있습니다.
직접 접합에서는 정전력으로 절연체와 (반)도체, 두 기판이 결합되는 정전 열 접합과 초기의 약한 결합 후에 열처리 과정을 통하여 두 기판 간에 실제적인 용융이 일어나면서 접합이 완성되는 용융 접합이 대표적입니다. 반면에 중간층을 사용하는 접합에는 실리콘과 금의 혼합물과 같은 솔더를 사용하는 접합, 유리 프릿이나 저융점 유리, 에폭시 등을 사용하는 접합과 열 압착 방법을 적용하는 접합 등이 있죠.
MEMS와 같은 초청정 고내구성 접합이 요구되는 경우에는 주로 접착제를 필요로 하지 않는 직접 접합 공정을 많이 이용하게 됩니다. 이를 통하여 청정하고, 접합될 기판들 간에 정렬이 잘 되는 접합이 가능하고 집적 회로 공정과 친화성이 있으며, 완전한 고체 상태에서의 접합, 대면적 접합, 웨이퍼 레벨의 접합, 그리고 강하며 안정적인 접합을 이룰 수 있죠.
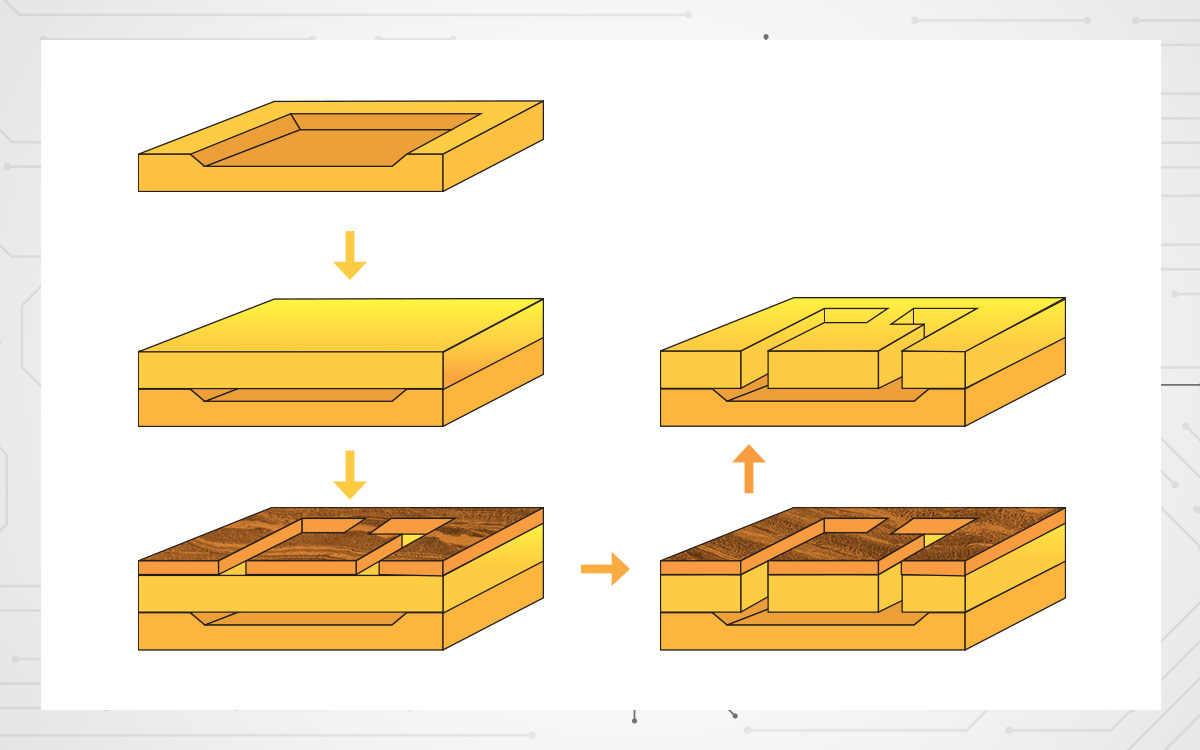
접합 공정은 비단 밀봉(sealing)이나 패키징에만 사용되지는 않습니다. 이에 더하여 보다 복잡한 3차원 MEMS 구조물을 만드는 데에도 효과적으로 이용할 수 있죠. 예를 들어 두 기판을 각각 임의의 형태로 가공을 하고, 둘을 접합한 다음에 패터닝과 식각 공정을 추가하면 다소 복잡한 3차원 구조물을 좀 더 쉽게 만들 수 있습니다. 그리고, 접합 공정 후에 한 쪽 기판을 완전히 제거하면, 공정 온도나 식각 등에서 함께 만들어질 수 있는 구조물이나 소자들이 하나의 기판 위에 놓일 수도 있습니다.
이와 같이 함께 만들기 어려운 소자를 각각 별도의 기판 위에 만들어서 다른 기판으로 이동하는 기술을 전사(transfer)라고 하죠. 기판 접합 공정을 활용하면, 접합, 전사, 3차원 구조물 제작, 패키징 과정이 웨이퍼 레벨에서 이루어지고, 최종 공정이 마무리되어 소자가 완성된 뒤 개별 칩으로 나누는 것이 가능합니다. 이러한 웨이퍼 레벨 가공 후 패키징 공정은 개별 칩들로 나눈 다음에 후속 공정을 진행하는 다이 레벨 공정에 비해 생산에 걸리는 시간이 줄어들고 단위 시간에 생산할 수 있는 수량이 증가하여 생산성 향상을 이룰 수 있습니다.
밀봉과 패키징, 감싸고 보호하기
MEMS는 기본적으로 움직이거나 진동하는 구조물을 기반으로 합니다. 따라서 안정적인 작동을 위해서는 구조물들이 안정적인 환경, 즉 움직임에 있어서 공기 저항 등을 최소화할 수 있어야 하며, 또한 주변의 습기나 반응성 기체들과 반응, 질량이나 모양에 변형이 있어서도 안됩니다. 따라서, 구조물들은 진공 혹은 반응을 일으키지 않는 비활성 기체로 채워진 공간 안에 놓여야 하는 경우가 많죠.
이에 더하여 MEMS가 센서로 이용될 경우, 센서는 측정하고자 하는 신호를 받아들여야 합니다. 신호가 생화학 물질이나 기체, 혹은 액체일 경우, 이 때는 감지부, 즉 MEMS의 구조물 부분이 밖으로 드러나야 하죠. 주변 회로부는 보호되면서. 이상과 같이 MEMS에서는 진공이나 특정 공간 안에서의 밀봉, 혹은 회로부를 제외한 선택적인 개봉, 그리고 밀봉된 공간 안으로부터 밖으로의 전기적인 연결 등을 요구하며 따라서 기본 반도체 공정과는 많이 다른 패키징을 요구하는 경우가 종종 발생합니다.
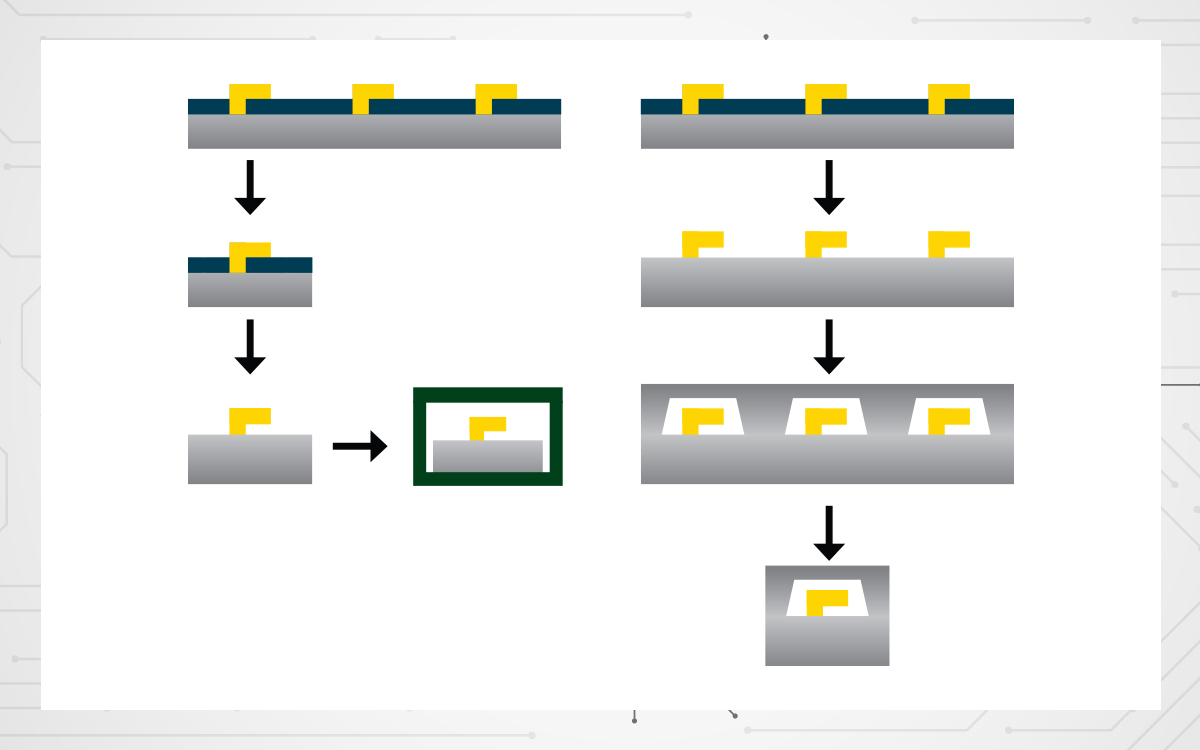
이와 함께 일반적인 패키징에서도 칩 레벨 패키징보다는 웨이퍼 레벨 패키징을 선호하지만, 특히 MEMS에서는 기계적인 충격에 다소 약한 부분들이 칩 내에 존재하기에 웨이퍼 레벨 패키징으로 필요성이 더 큽니다. 즉, 웨이퍼 단위로 패키징을 한 다음에 칩으로 잘라내는 방식이죠. 이러한 웨이퍼 레벨 패키징에서는 기판 접합 방식 등을 통하여 MEMS 구조물의 공간이나 환경을 충분히 제공하여 주고 칩으로 분리하여야 합니다.
MEMS 구조물에 특정 공간을 제공하여 주기 위해서는 덮개(cap)가 필요하며, 따라서 다양한 소재와 모양의 덮개들이 역시 MEMS 공정, 즉 미세 가공과 접합을 통하여 MEMS 구조물이나 소자를 덮게 됩니다. 가속도와 각속도를 측정하는 관성 센서류처럼 움직임이 필요할 경우, 압력 센서처럼 내부에 기준압이 유지되어야 할 경우, 외팔보를 이용한 센서들처럼 공명과 공진과 같은 고유 진동이 필요할 경우, 그리고 표면 탄성파 필터나 스위치 등에는 내부가 진공, 혹은 비활성 기체로 채워진 공간이 반드시 필요하게 되죠. 이러한 패키징에서는 특히 웨이퍼 레벨 공정, 기밀 밀봉(hermetic sealing), 패키징 크기의 소형화, 그리고 내구성과 신뢰성 등이 더욱 중요합니다.
그리고 다양한 가공 기술들
습식 식각, 이를 이용한 실리콘 몸체 및 표면 미세 가공, 비실리콘의 가공, 그리고 접합 및 패키징 등은 MEMS 공정에서 기본이 되는 부문입니다. 이에 더하여 좀 더 특수한 소재로 좀 더 특별한 구조물을 얻기 위하여 실로 다양한 가공, 공정들이 사용되고, 새로 등장하고 있죠. 워낙 종류가 많아 요약이나 정리를 하기가 만만찮지만, 나름 정리를 하여 보겠습니다.
먼저, 도구와 마스크 중에서 어떤 것을 주로 사용하는지가 포인트입니다. 도구로 깎거나 다듬어가는 공정, 혹은 마스크로 패터닝을 한 후에 식각을 하는 공정의 구분이죠. 도구를 사용하는 경우의 하나는 물리적인 가공 수단들을 사용하는 방법으로 절단, 연마, 밀링, 전기 방전 가공(Electric Discharge Machining, EDM), 전기화학적인 가공(Electro-Chemical Machining, ECM), 펀칭, 프레스 가공, 그리고 사출 성형 등을 들 수 있습니다. 다른 하나는 높은 에너지의 빔을 사용하는 경우로, 레이저나 전자선, 혹은 이온빔 등으로 가공을 하는 방법이죠. 마스크 패터닝을 이용하는 경우에는 비등방성과 등방성 가공으로 구분할 수 있는데, 비등방성 가공에는 결정 의존성 습식 식각, 그리고 빔을 이용한 가공들과 LIGA까지 포함이 됩니다. 등방성 가공에는 등방성 습식 식각을 비롯하여 플라즈마 등을 이용한 건식 식각, 그리고 전기 주조(electroforming)까지 들고 있습니다. 건식 식각은 비등방성도 강하지만 빔 가공에 비해서는 직진 방향성이 다소 약하여 등방성 가공으로 구분하였네요.
실리콘 반도체 이외의 공정을 기반으로 한 여러 MEMS 관련 공정들 중에서 대표적인 것이 LIGA 공정입니다. LIGA는 독일어로 Lithographie, Galvanoformung, Abformung의 약자이며 각각의 단어들은 사진 식각(lithography), 전기 도금(electroplating), 그리고 조형(molding)을 뜻합니다. 용어 그대로 사진 식각으로 틀을 만들고 전기 도금으로 채운 뒤 조형을 하는 방식이죠. 사진 식각에 사용되는 감광성 레지스트(PR)의 두께가 곧 조형물의 높이를 결정하니, 종횡비를 높이기 위해서는 에너지가 큰 x-ray 등으로 두꺼운 PR에 대해 노광을 하였으나, SU-8 등 두께를 증가시켜도 일반적인 광원에 감응할 수 있는 PR들이 개발되어 공정이 보다 간단해졌죠.
공정 순서를 살펴보면 먼저, 도전성이 있는 기판 위에 PR을 두껍게(제작될 구조물의 높이에 해당) 도포하고, 마스크 패턴을 사용하여 노광 후 현상을 하여 PR 구조물을 만듭니다(사진 식각 공정). 다음으로 전기 도금을 하여 금속으로 PR 구조물 틀을 채우고 PR을 제거하면 금속 틀이 만들어지죠(전기도금). 이 들을 이용하여 원하는 소재를 넣어 구조물을 찍어냅니다(조형). 제작되는 구조물의 높이는 노광 후 현상되는 PR의 두께에 해당하며, 폭은 패터닝된 PR의 모양과 치수로 결정이 되죠. 이러한 LIGA 공정을 이용하면, 다양한 재료들을 사용하여 종횡비가 높고, 형상이 자유로운 부품들을 만들 수 있습니다.
즉, 몸체 미세 가공과 같이 두껍고 내구성이 있는 3차원 구조물들을 표면 미세 가공에서의 설계 자유도로 제작이 가능하죠. 다만, 각각의 부품들이 개별적으로 만들어지므로 제작 후 별도의 조립 기술이 뒷받침되어야 합니다.
결국 MEMS 공정 기술은 기존 반도체 집적회로 공정과 기본적인 MEMS, 미세 가공 공정, 이에 더하여서 기계, 신소재, 화학, 나아가서는 생화학 공정까지 어우러진, 실로 무수한 공정들의 따로 또 같이, 조화로 이루어지며, 이들 결과물에 대한 분석과 평가 또한 매우 다양합니다. 지식의 깊이보다는 넓이, 여기에 반짝이는 아이디어와 기교가 함께하는 흥미로운 분야임에는 틀림이 없죠.

